晶體管越來越小,但是高性能計算需求越來越高,有些人就反其道而行之,嘗試制造超大芯片。
之前我們就見識過Cerebras Systems打造的世界最大芯片WSE,擁有46225平方毫米面積、1.2萬億個晶體管、40萬個AI核心、18GB SRAM緩存……并得到了美國能源部的青睞和部署。

現在,臺積電、博通聯合宣布,雙方將利用晶圓上芯片封裝(CoWos)技術,打造面積達1700平方毫米的中介層(Interposer),是芯片蝕刻所用光掩模(光罩)尺寸極限858平方毫米的整整兩倍。
這樣規模的中介層顯然是無法一次性單個制造出來的,臺積電實際上是同時在晶圓上蝕刻多個中介層,然后將它們連接在一起,組成一個整體。
工藝上,臺積電也用上了最先進的5nm EUV(N5),它將在今年上半年投入量產。
所謂中介層,用途就是串聯不同裸片(Die)的橋梁,因為隨著現代芯片日益復雜,制造單個大型SoC的代價越來越大,所以行業普遍開發出了各種新的封裝技術,將不同的小芯片、模塊整合在一起,構成一顆大芯片。
博通就計劃用這個龐大無比的中介層,封裝多個SoC芯片,以及六顆HMB2內存,單顆容量16GB,總容量達96GB/s,帶寬也高達2.7TB/s。
看這規格,應該是三星最新的HBM2E。
臺積電和高通未透露這種龐大芯片的具體規格,只是說將用于高性能計算領域。
另外,臺積電還在改進CoWoS封裝技術,所以未來不排除面積超過1700平方毫米的更大芯片。
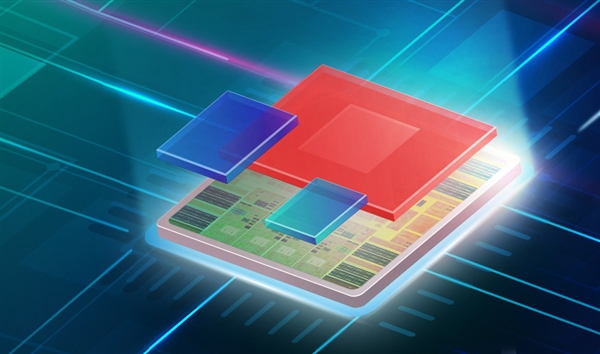
作者:上方文Q
本站內容除特別聲明的原創文章之外,轉載內容只為傳遞更多信息,并不代表本網站贊同其觀點。轉載的所有的文章、圖片、音/視頻文件等資料的版權歸版權所有權人所有。本站采用的非本站原創文章及圖片等內容無法一一聯系確認版權者。如涉及作品內容、版權和其它問題,請及時通過電子郵件或電話通知我們,以便迅速采取適當措施,避免給雙方造成不必要的經濟損失。聯系電話:010-82306118;郵箱:aet@chinaaet.com。

