文獻標識碼: A
DOI:10.16157/j.issn.0258-7998.2017.01.003
中文引用格式: 侯斌,邢鼎,張戰國,等. 4H-SiC MESFET特性對比及仿真[J].電子技術應用,2017,43(1):13-15,19.
英文引用格式: Hou Bin,Xing Ding,Zhang Zhanguo,et al. The characteristic comparison and simulation of 4H-SiC MESFET[J].Application of Electronic Technique,2017,43(1):13-15,19.
0 引言
4H-SiC MESFET作為下一代大功率微波器件的首選,具有靜態工作電壓高、輸出阻抗大、線性化程度理想、器件通用性好及設計成本低等優點[1,2]。傳統的4H-SiC MESFET器件雖然在理論上具有很好的直流和射頻特性,但在實際中,由于擊穿電壓和漏電流的提高,在一定程度上為相互制約的關系,導致功率密度達不到更高的要求。目前科學界通過改變4H-SiC MESFET結構的尺寸、形狀等手段來提高4H-SiC MESFET器件的性能。而雙凹柵結構4H-SiC MESFET和階梯柵結構MESFET的提出,對柵結構的改變提供了良好的思路。對于階梯柵4H-SiC MESFET的研究表明,當階梯柵的數目越多時,器件的各項特性將越好[3]。所以階梯的數目趨向于無窮時,階梯的形狀就被微分為一個斜坡。
1 階梯柵和坡形柵4H-SiC MESFET的結構
圖1為階梯柵結構MESFET的剖面圖,從圖中可以看出,MESFET的柵部分由上柵和下柵兩部分構成,上柵部分為長方形結構,柵長為LG;下柵部分為倒階梯狀結構,柵長為W,下柵通過刻蝕延伸到N型溝道區。

圖2是將階梯數目極限后所產生的結構,器件的結構由一個半絕緣的襯底、一個P型的緩沖層、一個N型溝道和高摻雜的n型覆蓋層從下而上堆疊而成,堆疊層表面通過濺射金屬引出柵(G)、源(S)、漏電極(D)。坡形柵MESFET結構的尺寸如下:柵長度LGU為0.7 μm,柵源間距LGS為0.5 μm,柵漏間距LGD為1.8 μm,下柵高度為0.06 μm,N型溝道厚度為0.25 μm。摻雜濃度為3×1017cm-3,P型緩沖層厚度為0.5 μm,摻雜濃度為1.4×1015cm-3,柵的肖特基接觸金屬為鎳[4]。

2 器件的物理模型及參數
對于4H-SiC MESFET的研究,通常采用漂移-擴散模型、熱力學方程模型和流體力學模型來描述[5]。本文對坡形柵MESFET及其他結構的仿真中,由于牽扯到高溫,漂移擴散模型不可用,流體力學模型相對于熱力學模型速度慢得多,所以采用熱力學模型進行分析[6]。
熱力學模型假設載流子和晶格相互熱平衡,所以可以假定系統溫度統一,電子和空穴的電流密度方程可以通過式(1)和式(2)表示:

本文的仿真軟件采用ISE-TCAD,描述坡形柵MESFET器件的基本模型有能帶變窄模型、遷移率模型、雪崩離化模型和復合模型等。
3 不同柵結構的4H-SiC MESFET物理特性對比及坡形柵結構的優化
3.1 雙凹柵結構和階梯柵結構4H-SiC MESFET物理特性對比
在不同柵結構的4H-SiC MESFET器件中,具有代表性的有雙凹柵MESFET和階梯柵MESFET。雙凹柵MESFET的結構剖面圖如圖3所示。
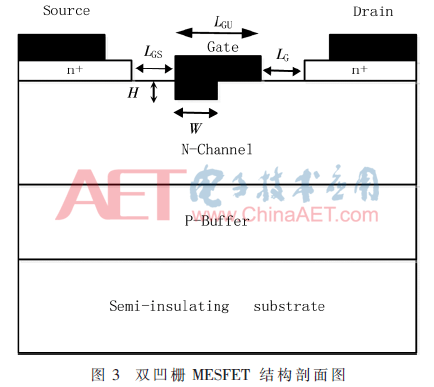
從圖3中可以看出,雙凹柵結構和階梯柵結構4H-SiC MESFET的區別為下柵部分,雙凹柵4H-SiC MESFET的下柵部分為具有長度為W的長方形柵,而階梯柵的下柵部分為階梯狀的柵。
3.1.1 雙凹柵和階梯柵電流輸出特性對比
在不同柵壓下(VG=0 V、-3 V、-6 V、-9 V),階梯柵和雙凹柵MESFET結構的直流輸出I-V特性曲線如圖4所示。
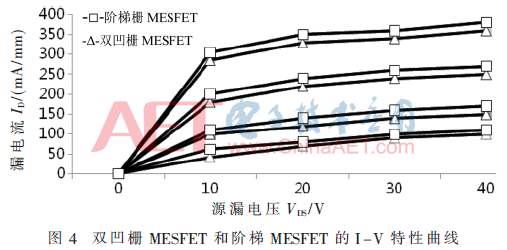
從圖4中可以看出,在不同的柵壓下,階梯柵MESFET的飽和漏極輸出電流大于雙凹柵MESFET。這是因為對于4H-SiC MESFET,溝道區的等效電阻主要由耗盡區的大小決定,隨著低柵部分階梯數目的變化,耗盡區隨之改變,提高階梯數目使得溝道電阻減小,使漏電流得到提高。在柵壓VG=0 V時,階梯柵MESFET的飽和漏電流為391 mA/mm,比同條件下的雙凹柵MESFET提高了5.9%。
3.1.2 雙凹柵和階梯柵的擊穿電壓對比
圖5為雙凹柵MESFET和階梯MESFET的擊穿電壓曲線,從圖中可以看出,階梯柵MESFET的擊穿電壓為52 V,比雙凹柵MESFET提高了4%。這是因為,要使得器件發生擊穿,器件內部的電場則需要更高的電壓。因此,階梯柵MESFET的擊穿電壓大于雙凹柵MESFET[7]。

3.1.3 最大輸出功率對比分析
通過階梯MESFET與雙凹柵MESFET的飽和漏電流和擊穿電壓可以計算出兩種結構的最大輸出功率密度Pmax:

其中,Id是4H-SiC MESFE器件的飽和漏電流,VB是擊穿電壓,Vknee是膝點電壓。
從式(3)可以看出,由于階梯柵MESFET的擊穿電壓和飽和漏極電流均大于雙凹柵MESFET,因此其最大輸出功率密度也大于雙凹柵MESFET,可見階梯柵MESFET比雙凹柵MESFET具有更加優秀的擊穿特性和功率特性。
3.2 階梯柵結構和坡形柵結構4H-SiC MESFET物理特性對比及優化
在圖2中描述了坡形柵MESFET的結構,在此引入坡形柵MESFET的特征參數(EPCG),即坡形柵的終點,定義上柵和下柵的交點為坡形柵的終點。圖6中①、②、③、④分別代表了1/4柵、1/2柵、3/4柵和全柵的坡形柵MESFET。圖7為坡形柵和階梯柵MESFET漏電流-漏源電壓對比圖。


從圖7中可以看出,在VDS較小,即器件工作在線性區時,坡形柵MESFET和階梯柵MESFET的漏電流基本相同,但當VDS進一步增大,這幾種結構就有了顯著差異。對于坡形柵MESFET,由于EPCG的不同,導致器件溝道區內的耗盡層發生改變,使得最大飽和漏電流發生變化。當EPCG為1/2柵時,最大飽和漏電流取得最大值,在VG=0 V、VDS=40 V的條件下達到了545 mA。而EPCG為1/4柵、3/4柵和全柵時,最大飽和漏電流不如EPCG為1/2柵時,也就是說,當EPCG從全柵移動到3/4柵、1/2柵時,由于溝道層內的耗盡區不斷減小,使得溝道不斷展寬,導致最大飽和漏電流不斷增大;而EPCG從1/2柵移動到1/4柵時,溝道耗盡區邊界的電流集邊效應將會越來越嚴重,這會使得溝道減小,導致最大飽和漏電流減小。因此,當EPCG為1/2柵時,坡形柵MESFET的漏電流達到最大值。
圖8為EPCG分別為1/4柵、1/2柵、3/4柵和全柵時,坡形柵MESFET的擊穿電壓對比圖。從圖中可以看出,當EPCG為1/2柵時,坡形柵MESFET的擊穿電壓最大達到57.5 V;而當EPCG為3/4柵時,坡形柵MESFET的擊穿電壓最小,為48 V。這是因為,在EPCG為3/4柵和全柵時,由于柵結構下方的終點距離漏測較近,使得柵漏邊緣形成了較大的電場,因此更易發生擊穿。而EPCG為1/4柵和1/2柵時,漏測邊緣更接近于常規4H SiC MESFET,因此擊穿電壓較高。

4 結論
本文對比了雙凹柵結構和階梯柵4H-SiC MESFET的電流電壓直流特性。結果表明,階梯柵4H-SiC MESFET具有更好的直流特性。通過對階梯柵的極限化處理,引出了坡形柵的4H-SiC MESFET結構,以及坡形柵的4H-SiC MESFET的特征參數-坡形柵的終點(EPCG)。仿真結果表明,當EPCG為1/2柵,最大飽和漏電流取得最大值,在VG=0 V、VDS=40 V的條件下達到了545 mA;EPCG為1/4柵、3/4柵和全柵時,最大飽和漏電流均不如EPCG為1/2柵時取得的最大值。
參考文獻
[1] SUDOW M,ANDERSSON K,BILLSTROM N,et al.An SiC MESFET-based MMIC process[J].Microwave Theory and Techniques,IEEE Transaction on,2006,54(12):4072-4078.
[2] WILLARDSON R K,WEBER E R.SiC material and devices[M].Academic Press,1998.
[3] JIA H,ZHANG H,XING D,et al.A novel 4H-SiC MESFET with ultrahigh upper gate[J].Superlattices and Microstructures,2015,86:372-378.
[4] MEAD C A.Schottky barrier gate field effect transistor[J].Proceeding of the IEEE,1966,54(2):307-308.
[5] 劉恩科.半導體物理學(第七版)[M].北京:國防工業出版社,2011.
[6] 任雪峰,楊銀堂,賈護軍.4H-SiC MESFET直流I-V特性解析模型[J].半導體技術,2008(2):129-132.
[7] RAMEZANI Z,OROUJI A A,AGHAREZAEI H.A novel symmetrial 4H-SiC MESFET:an effective way to improve the breakdown voltage[J].Joural of Computation Elctronics,2015(1).
作者信息:
侯 斌,邢 鼎,張戰國,臧繼超,馬 磊
(航天科技集團九院七七一研究所,陜西 西安710000)

